
该材料适用于PoP, CSP构造的半导体封装基板。
特点
X、Y方向的膨胀系数小(α1,α2)、弹性率高可大幅降低翘曲。
因使用和低膨胀玻璃纤维的组合(LH)型,CTE可达到2.0ppm/℃以下。
技术内容及特性
| 项目 | 条件 | 单位 | MCL-E-770G(LH) | MCL-E-770G | |
|---|---|---|---|---|---|
| 玻璃态转化温度(Tg) | TMA | ℃ | 260~280 | 260~280 | |
| 热膨胀系数 | X,Y | α1 | ppm/℃ | 1.5~2.0 | 4~6 |
| α2 | 0~1.0 | 1~2 | |||
| Z | α1 | 8~13 | 13~18 | ||
| α2 | 70~90 | 90~110 | |||
| 弯曲模量 | A | GPa | 34~36 | 30~32 | |
| 半加成制程积层耐热性 | 260℃reflow | cycle | >20 | >20 | |
| 相对介电常数(Dk) | 1GHz※1 | - | 3.9~4.1 | 4.1~4.3 | |
| 介电损耗角正切(Df) | 1GHz※1 | - | 0.004~0.006 | 0.004~0.006 | |
※1 Measured by Triplate-Line Resonator
4层板翘曲评价结果(4层板构造)

介电性能 Dielectric Property (vs.frequency) JPCA-TM001
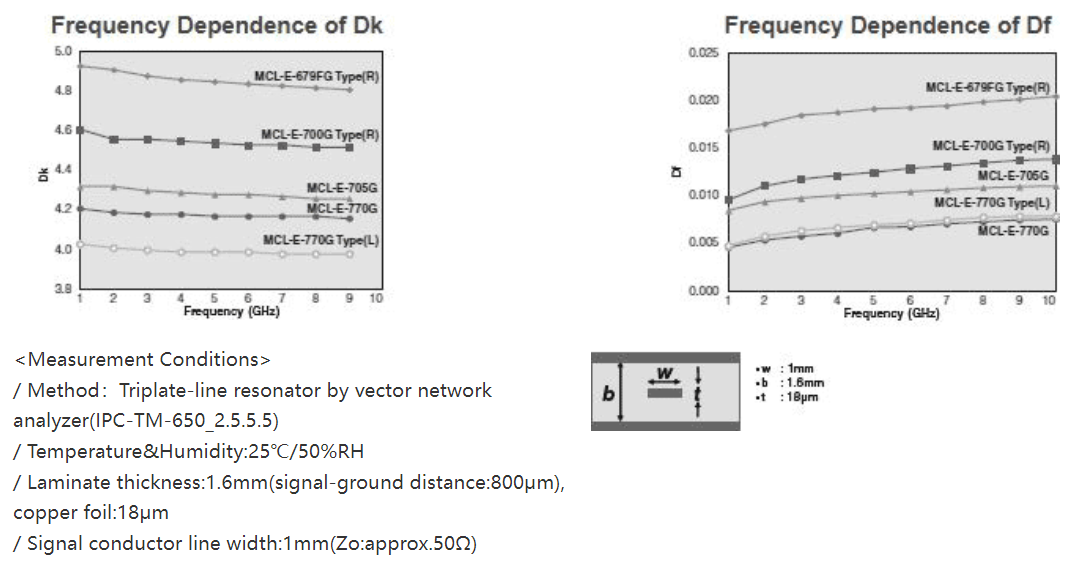
用途
适用于半导体封装基板、积层内层芯材等
*本文章中的数据是在力森诺科集团的实验条件下所测得的结果。
